Implantación iónica como instrumento para la nanoestructuración de semiconductores
Resumen
En este trabajo se llevó a cabo el estudio de la interacción entre iones de baja energía (25 keV) y semiconductores, así como sus aplicaciones en nano-electrónica. El estudio se concentró en uno de los efectos que resultan de la interacción entre un haz de iones y un sólido: la implantación iónica.
Para realizar este estudio se utilizó como ion primario el silicio con carga positiva (Si+) para implantar una oblea comercial de germanio (Ge). Las muestras implantadas fueron posteriormente tratadas térmicamente, después se caracterizaron para determinar sus propiedades, químicas, estructurales, morfológicas y ópticas. Los resultados sugieren potenciales aplicaciones para fabricar dispositivos emisores de luz.
Palabras clave: implantación iónica; semiconductores; nanoestructuras
Abstract
A detailed study of the interaction between low energy ions (25 keV) and semiconductors was performed, as well as their applications in nanoelectronics. The study was focused on one of the sputtering effects: ion implantation.
The selected primary ion was silicon with positive charge (Si+) and the semiconductor was germanium (Ge). After ion implantation, the samples were thermally treated and characterized in order to study their chemical, structural, morphological and optic properties. The results suggest potentially applications to fabricate optic devices.
Keywords: ion implantation; semiconductors; nanostructures
1.- INTRODUCCIÓN
Inicialmente, el efecto de la interacción entre una partícula energética y la superficie de un sólido se observó hace más de 150 años en un tubo de descarga de gas eléctrico, en donde el gas ionizado provocó la erosión del cátodo (R. Behrisch, 2007). El efecto del desgaste de una superficie, es decir la remoción de átomos de una superficie provocada por la incidencia de partículas energéticas se conoce como "sputtering" en inglés, y en español se denomina "pulverización catódica".
Por otra parte, el término "blanco" es una traducción literal de la palabra "target" en inglés, y se utiliza comúnmente para referirse al lugar donde se realizará el bombardeo de iones.
Al llevarse a cabo el proceso de sputtering el cual es un proceso complejo, se generan diversos efectos asociados, siendo uno de ellos la implantación iónica. En este caso, los iones que penetran en el blanco se detienen a una determinada profundidad creando un perfil de implantación que presenta una distribución gaussiana, en la gran mayoría de los casos. El potencial de aceleración de los iones controla la profundidad de implantación y la concentración máxima de iones implantados está determinada por la dosis de implantación. Por otro lado, en el interior del sólido las colisiones con los átomos del blanco provocan que éstos se desplacen de su posición inicial, por lo que se originan defectos en una capa cercana a la superficie que se denomina "capa amorfizada". Para reparar los daños en la red cristalina, es necesario realizar un recocido térmico después de la implantación. Mediante el recocido se recristaliza la red y se activan las impurezas introducidas como dopantes. El proceso de re-cristalización procede a través de la epitaxia en fase sólida sobre la capa cristalina que se encuentra bajo la capa implantada (J. S. Williams, 1984).
La aplicación más conocida de la implantación iónica es en la industria de semiconductores, donde se utiliza como una técnica para dopar obleas y, además para la fabricación de dispositivos como: transistores, diodos, celdas solares, etc. Esta tecnología se ha utilizado a gran escala desde 1974 cuando la patente de W. Shockley expiró (I. Yamada).
Por lo general, el rango de energía en el que se trabaja es de 50 - 300 keV (P. L. Grande, 1991). La técnica se ha utilizado eficientemente durante más de 40 años y ha sido vastamente estudiada, por lo que existen muchos reportes científicos de implantación iónica en el régimen de alta energía. Sin embargo, la implantación iónica no ha sido ampliamente estudiada en el rango de baja-media energía (< 30 keV). En la última década, se estudió la formación de una capa activa muy delgada (< 20 nm) mediante la implantación de boro (B), arsénico (As) y fósforo (P) en silicio (Si), denominada "implantación superficial" (shallow implantation) (D. N. Jamieson, 2005). Esta técnica se utiliza para fabricar dispositivos de nueva generación, pero aún no se han publicado estudios sistemáticos sobre implantaciones de baja energía en diferentes matrices ion-blanco.
Otra de las aplicaciones importantes de la implantación iónica toma lugar al considerar una alta dosis de implantación. Si se implanta un blanco con una dosis lo suficientemente alta como para alcanzar una concentración que exceda el límite de solubilidad del elemento implantado en la matriz, y posteriormente se realiza el recocido de este sistema sobresaturado, el resultado es una separación de fases donde el elemento implantado forma nano-partículas (U.B. Singh, 2014; T. Lu, 2006 ).
2.- PROCEDIMIENTO EXPERIMENTAL
2.1.- FABRICACIÓN DE LAS MUESTRAS
En la Fig. 1 se muestra esquemáticamente el proceso de fabricación de los semiconductores nano-estructurados. Los experimentos se llevaron a cabo utilizando obleas comerciales de Ge, las muestras de tamaño de 1x1 cm2 aproximadamente, se cortaron utilizando una punta de diamante. La limpieza se llevó a cabo a temperatura ambiente al sumergir las muestras de manera consecutiva en cada uno de los solventes: acetona, etanol y agua desionizada, utilizando una tina de ultrasonido durante 5 min (para cada substancia). Finalmente, las muestras fueron enjuagadas en agua desionizada y secadas mediante una pistola de nitrógeno.
La implantación iónica se realizó en un implantador comercial, especificando la dosis y la energía de implantación. En este trabajo la dosis y energía de implantación seleccionadas fueron 1x1016 iones/cm2 y 25 keV, respectivamente.
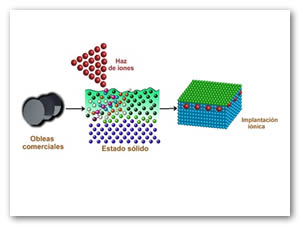
Fig. 1.- Representación general del proceso de preparación de las muestras: obleas comerciales se bombardearon con iones a diferentes energías para formar una capa delgada cercana a la superficie implantada.
El recocido del blanco de Ge después de ser implantado con iones de Si+ se realizó en atmósfera de nitrógeno cromatográfico durante 5 minutos a temperatura de 973 K. El proceso se llevó a cabo en el modo “rápido” (Rapid Thermal Annealing RTA).
Adicionalmente, sobre la muestra recocida se realizó un decapado iónico con Ar+ (3.0 keV) de las muestras recién implantadas y recocidas para remover material de la superficie en una zona seleccionada.
2.2.- CARACTERIZACIÓN DE LAS MUESTRAS
Utilizando simulaciones Monte Carlo mediante el programa SRIM, se calculó el perfil de distribución de iones implantados y de las vacancias generadas en el proceso de implantación.
Mediante la microscopía de fuerza atómica (Atomic Force Microscopy: AFM) se realizó el estudio de las muestras decapadas. Las mediciones se llevaron a cabo en el modo de semi-contacto utilizando una punta con un radio de curvatura de 10 nm. Fueron tomadas micrografía de 5x5 micras con resolución de 256 pixeles a una tasa de adquisición de 1 Hz. El equipo utilizado es modelo Solver Next de la marca NT-MDT.
Por otra parte, la medición simultánea de Raman-AFM provee información complementaria de las propiedades morfológicas de la muestra (AFM) y de su composición química (Raman). Al realizar un mapeo sobre un área determinada, podemos identificar la composición química en áreas localizadas de la superficie.
En este trabajo, la técnica combinada Raman-AFM se realizó utilizando un equipo NTEGRA Spectra de la marca NT-MDT. Estas dos técnicas en conjunto permiten la obtención de mapas de composición química en 2D y también en 3D. Durante la adquisición de este tipo de imágenes, se registra el espectro completo por lo que es posible visualizar el espectro Raman localmente en cada uno de los puntos que componen la imagen.
3.- RESULTADOS Y DISCUSIÓN
Utilizando el programa SRIM mediante simulaciones Monte Carlo, se obtuvieron los perfiles de implantación de los átomos de Si, así como también la distribución de los defectos generados en el proceso. En la Fig. 2 se muestran (a) el perfil de distribución de Si implantado en Ge y (b) la distribución de vacancias generadas en el blanco. Se calculó que el valor máximo de la concentración de Si es de 4.7x1021 átomos/cm3 a una profundidad de 28 nm.

Fig. 2- Perfiles generados mediante SRIM, Ge con implantación de Si: (a) distribución en profundidad de iones implantados y (b) distribución de vacancias.
Es bien conocido que la porosidad puede ser inducida en el Ge cuando éste es implantado con iones pesados (L. Bischoff, 2011; R. Böttger, 2013; R. Böttger, 2013; R. Böttger, 2012; I.H. Wilson, 1982; B.R. Appleton, 1982), por lo general esos experimentos utilizan como ion primario Au+, Bi+, Ag+ y Ge+. Sin embargo, existen pocos resultados acerca de la porosidad inducida en Ge utilizando iones de Si+ en el rango de baja energía. Utilizando AFM se estudiaron las muestras decapadas con iones de Ar+. El decapado se realizó en un área delimitada con el objetivo de remover el material cercano hacer emerger sobre la superficie la región subyacente a ésta.
En la Fig. 3 se muestra de manera esquemática el proceso de erosión iónica y se señala la zona estudiada mediante AFM que está representada por el cuadro rojo punteado. (a) corresponde al cristal de Ge antes de la implantación, (b) es la muestra implantada y (c) después del recocido térmico. De la muestra recién implantada se retiraron 135 nm de la superficie y se observaron los poros, mientras que en la recocida fueron retirados 346 nm para observar las estructuras porosas.
Para identificar las muestras, de aquí en adelante nos referiremos a la muestra con superficie porosa como "decapada", ya que fue erosionada con iones.
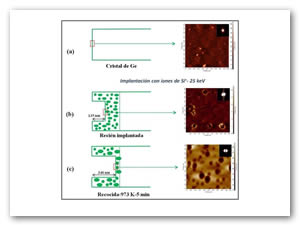
Fig. 3.- Diagrama esquemático del proceso de erosión de la superficie junto con el correspondiente análisis AFM. Se revela la formación de poros por debajo de la superficie. (a) cristal de Ge, (b) muestra recién implantada y (c) recocido térmico a 973 K.
Se piensa que la estructura porosa surge como resultado del siguiente proceso: la irradiación continua de iones en el proceso de implantación genera defectos, tales como átomos adsorbidos, intersticiales y vacancias, los átomos adsorbidos se re-absorben en el Ge amorfo más rápido que las vacancias, por lo que se genera un exceso de vacancias, éstas se unen para formar grupos y, a continuación, este proceso conduce a la formación de poros por debajo de la superficie (L. Romano, 2010; R. Böttger, 2013).
En la Fig. 4 se encuentran los resultados del estudio combinado Raman-AFM de la superficie de Ge poroso que fue obtenida como resultado de decapar con iones de Ar+ la muestra recocida a 973 K. El objetivo fue hacer emerger sobre la superficie las estructuras porosas que se forman por debajo de ésta debido al bombardeo con iones de Si+ en el rango de baja energía. En (a) se tiene una imagen AFM en 2D de tamaño de 10x10 μm2 de la topografía, (b) análisis del perfil de altura señalado con una línea blanca en (a). Por otra parte, (c) muestra el mapa Raman 2D de la superficie de Ge porosa y en (d) el espectro Raman de los poros de mayor tamaño marcados en (c) como P1, P2 y P3.
En la Fig. 4 (c) el mapa Raman indica, por los contrastes de color, que los poros tienen una composición química diferente del resto de la superficie y al mismo tiempo entre cada uno de ellos. Esto es consistente con los espectros Raman mostrados en 4 (d), ya que en P3 se observa una composición química totalmente diferente de P1 y P2 y al observar los espectros correspondientes, se observa que el pico de GeO2 trigonal presenta mayor intensidad en P3.

Fig. 4.- Análisis Raman-AFM: (a) Topografía AFM, (b) análisis de la sección transversal marcada en (a) con una línea blanca, (c) Mapa Raman en 2D y (d) espectro Raman medido en los poros marcados en (c).
Lo relevante de estudiar la muestra con la técnica combinada, es realizar un intento de identificar la composición química local de la superficie. En este caso en particular, la composición en los poros.
La estructura porosa observada por AFM y los enlaces GeO2 (fases trigonal y tetragonal) detectados por espectroscopía Raman nos permiten sugerir que los poros están cubiertos con una película delgada de óxido de germanio.
4.- CONCLUSIONES
Se realizó implantación en el rango de baja energía de iones de silicio en un cristal de germanio, encontrándose que la implantación de silicio induce porosidad en el germanio lo que ya anteriormente había sido observado únicamente para iones pesados y energías muy altas en el rango de MeV. Por esta razón, resulta destacado que el efecto también se presente cuando la energía de implantación es baja. La formación de los poros se puede explicar como sigue: el bombardeo iónico genera la formación de vacancias e intersticiales. Debido a su movilidad, los intersticiales son absorbidos por la red cristalina más rápido que las vacancias, lo que genera un exceso de vacancias que se unen formando clústeres de vacancias que resultan en la formación de estructuras porosa.
Los poros fueron observados al realizar una erosión iónica de la superficie en un área localizada y la formación de poros de mayor tamaño se observó después del recocido térmico, lo que es lógico si consideramos que las vacancias se unen para formar poros. Además, el recocido en una atmósfera de bajo contenido de oxígeno resulta en la formación de óxido de germanio que recubre los poros.
AGRADECIMIENTOS
Los autores quisieran agradecer al Consejo Nacional de Ciencia y Tecnología (CONACYT) del gobierno mexicano por aportar los fondos para el desarrollo de este trabajo, en especial al proyecto CB-2012/176179.
BIBLIOGRAFÍA
B.R. Appleton, O.W. Holland, J. Narayan, O.E. Schow, J.S. Williams, K.T. Short, E. Lawson, Characterization of damage in ion implanted Ge, Appl. Phys. Lett. 41 (1982) 711–712. doi:10.1063/1.93643.
D.N. Jamieson, C. Yang, T. Hopf, S.M. Hearne, C.I. Pakes, S. Prawer, M. Mitic, E. Gauja, S.E. Andresen, F.E. Hudson, A.S. Dzurak, R.G. Clark, Controlled shallow single-ion implantation in silicon using an active substrate for sub-20‐keV ions, Appl. Phys. Lett. 86 (2005) 202101. doi:10.1063/1.1925320.
I. Yamada, Materials processing by cluster ion beams : history, technology, and applications, n.d.
I.H. Wilson, The effects of self‐ion bombardment (30–500 keV) on the surface topography of single‐crystal germanium, J. Appl. Phys. 53 (1982) 1698–1705. doi:10.1063/1.331636.
J.S. (James S. Williams, J.M. Poate, Ion implantation and beam processing, Academic Press, 1984.
L. Bischoff, W. Pilz, B. Schmidt, Amorphous solid foam structures on germanium by heavy ion irradiation, Appl. Phys. A. 104 (2011) 1153–1158. doi:10.1007/s00339-011-6396-y.
L. Romano, G. Impellizzeri, M. V. Tomasello, F. Giannazzo, C. Spinella, M.G. Grimaldi, Nanostructuring in Ge by self-ion implantation, J. Appl. Phys. 107 (2010) 84314. doi:10.1063/1.3372757.
P.L. Grande, F.C. Zawislak, D. Fink, M. Behar, Range parameters study of medium-heavy ions implanted into light substrates, Nucl. Instruments Methods Phys. Res. Sect. B Beam Interact. with Mater. Atoms. 61 (1991) 282–290. doi:10.1016/0168-583X(91)95631-M.
R. Behrisch and W. Eckstein, Sputtering By Particle Bombardment: Experiments And Computer Calculations From Threshold To MeV Energies (Topics In Applied Physics), (n.d.). http://www.clayton-usedcars.com/sputtering-by-particle-bombardment-experiments-and-computer-calculations-from-threshold.pdf ( 2007).
R. Böttger, A. Keller, L. Bischoff, S. Facsko, Mapping the local elastic properties of nanostructured germanium surfaces: from nanoporous sponges to self-organized nanodots, Nanotechnology. 24 (2013) 115702. doi:10.1088/0957-4484/24/11/115702.
R. Böttger, K.-H. Heinig, L. Bischoff, B. Liedke, R. Hübner, W. Pilz, Silicon nanodot formation and self-ordering under bombardment with heavy Bi 3 ions, Phys. Status Solidi - Rapid Res. Lett. 7 (2013) 501–505. doi:10.1002/pssr.201307127.
R. Böttger, K.-H. Heinig, L. Bischoff, B. Liedke, S. Facsko, From holes to sponge at irradiated Ge surfaces with increasing ion energy—an effect of defect kinetics?, Appl. Phys. A. 113 (2013) 53–59. doi:10.1007/s00339-013-7911-0.
R. Böttger, L. Bischoff, K.-H. Heinig, W. Pilz, B. Schmidt, From sponge to dot arrays on (100) Ge by increasing the energy of ion impacts, J. Vac. Sci. Technol. B, Nanotechnol. Microelectron. Mater. Process. Meas. Phenom. 30 (2012) 06FF12. doi:10.1116/1.4767269.
T. Lu, S. Dun, Q. Hu, S. Zhang, Z. An, Y. Duan, S. Zhu, Q. Wei, L. Wang, Ge nano-layer fabricated by high-fluence low-energy ion implantation, Nucl. Instruments Methods Phys. Res. Sect. B Beam Interact. with Mater. Atoms. 250 (2006) 183–187. doi:10.1016/j.nimb.2006.04.105.
U.B. Singh, D.C. Agarwal, S.A. Khan, S. Mohapatra, H. Amekura, D.P. Datta, A. Kumar, R.K. Choudhury, T.K. Chan, T. Osipowicz, D.K. Avasthi, Synthesis of embedded Au nanostructures by ion irradiation: influence of ion induced viscous flow and sputtering, Beilstein J. Nanotechnol. 5 (2014) 105–110. doi:10.3762/bjnano.5.10.
[a]* Sección Electrónica del Estado Sólido, Ingeniería Eléctrica, CINVESTAV-IPN, Av. IPN n. 2508, Col. San Pedro Zacatenco, D. F. C.P. 07360, Mexico ghernandez@cinvestav.mx
[b] Sección Electrónica del Estado Sólido, Ingeniería Eléctrica, CINVESTAV-IPN, Av. IPN n. 2508, Col. San Pedro Zacatenco, D. F. C.P. 07360, Mexico yuriyk@cinvestav.mx